Zerstörungsfreie Dünnschichtanalyse
Im extrem dynamischen Feld der Halbleitertechnologie ist Forschung und Entwicklung neben einem effektiven Qualitätsmanagement der Schlüsselfaktor für dauerhaften Erfolg. In beiden Bereichen sind innovative Messverfahren ein großer Vorsprung am hart umkämpften Markt. Eine elegante und auch zerstörungsfreie Methode in der Dünnschichtanalyse stellt die Ellipsometrie dar.
Die Ellipsometrie
ist ein etabliertes Messverfahren zur Bestimmung des Brechungsindex und der Dicke dünner Schichten. Das Verfahren ist nichtinvasiv, da es die Änderung der Polarisation zwischen eingestrahltem und reflektiertem Licht in Schichtsystemen analysiert. Die beiden wichtigsten Eigenschaften zur Charakterisierung kristalliner Schichtsysteme sind die Zusammensetzung, die sich im Brechungsindex widerspiegelt, und die Dicke. Im gerade entstehendem Markt für optische Anwendungen im mittleren Infrarotbereich ist die MIRell Photonics GmbH der weltweit einzige Anbieter von Ellipsometern mit Laserlichtquellen.
Wie funktioniert Ellipsometrie?
Licht mit definierter Polarisationsrichtung fällt unter einem Winkel auf die zu untersuchende Probe. An den Grenzfläche der einzelnen Schichten wird jeweils ein Teil des Lichts reflektiert, wobei sich abhängig vom Material und der Schichtdicke die Polarisationsrichtung ändert. Diese Änderung wird detektiert und mittels verschiedener Softwarealgorithmen analysiert, so dass schließlich das Schichtsystem modelliert werden kann. Dieses Modell spiegelt die gesuchten Messgrößen wieder.
Was sagen die Messwerte aus?
Die primären Werte aus dem errechneten Modell sind die Dicken und die Brechungsindices der einzelnen Schichten. Der Brechungsindex als physikalische Größe beschreibt das Verhalten von Licht im Material. Er basiert direkt auf Materialparametern wie der Dotierkonzentration oder der Materialzusammenstellung bei Halbleiterverbindungen. Die Kenntnis dieser beiden Messwerte bildet somit die Grundlage für jede Anwendung in der Photonik.

Schematische Darstellung des Messprinzips mit rotierendem Analysator. Adaptiert aus M. Neshat und N. P. Armitage: „Developments in THz range ellipsometry". https://arxiv.org/pdf/1305.3127.pdf (Mai 2013).
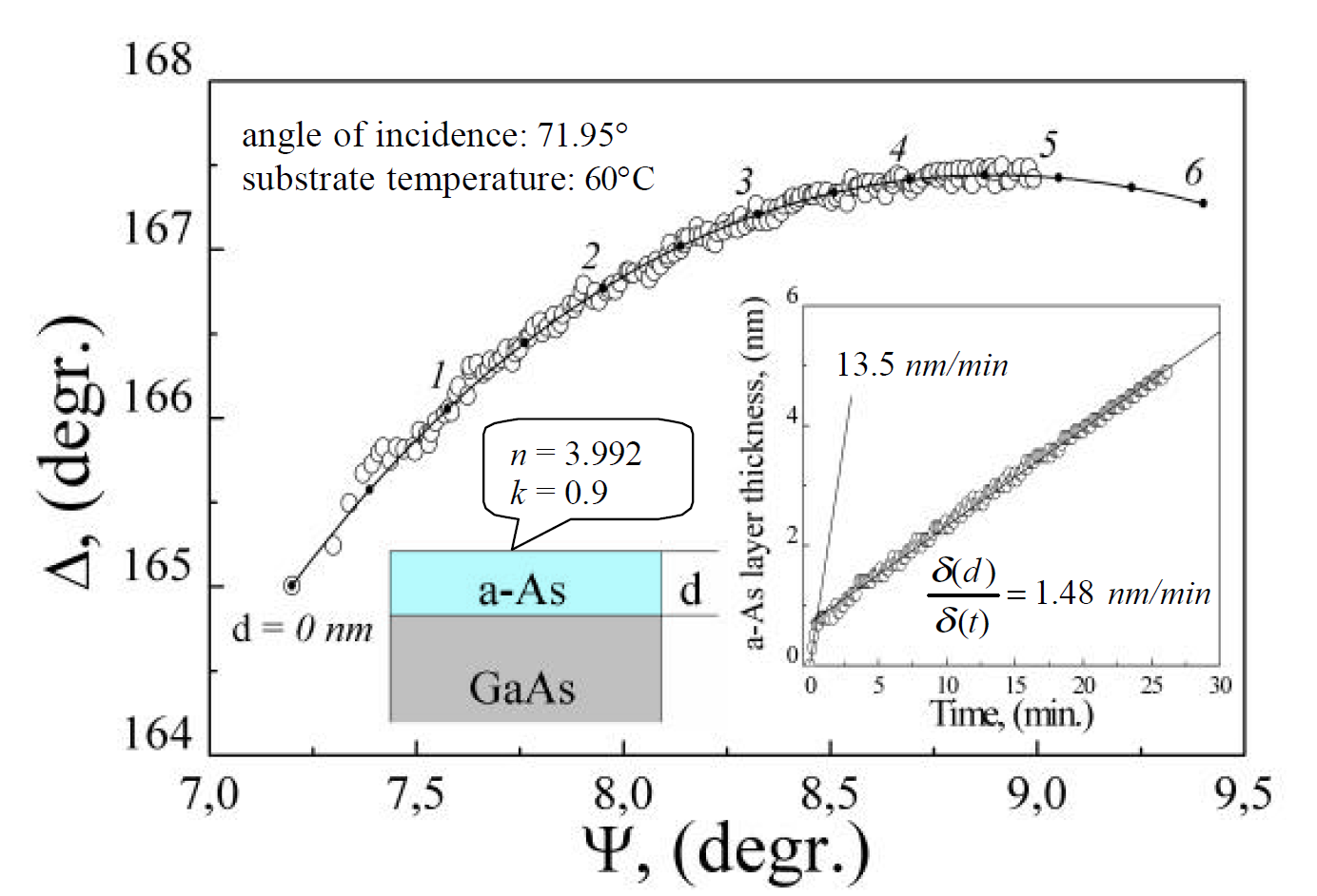
Beispielhaftes Resultat einer Messung zur Bestimmung des Dickenwachstums. Aus S.I. Chikichev und A.V. Vasev: „Condensation and sublimation of thin amorphous arsenic films studied by ellipsometry". https://arxiv.org/ftp/cond-mat/papers/0402/0402592.pdf.
